Лаборатория технологии микро- и наносистемной техники
Руководитель структурного подразделения д.ф-м.н. Амиров И.И.Основные направления исследований
МЭМС-переключатель для перспективных систем связи и радиолокации
МЭМС-переключатель сочетает в себе достоинства традиционно используемых электромагнитных и полупроводниковых реле и рассматривается в качестве основы электронной компонентной базы нового поколения. Изделие изготавливается методом поверхностной микрообработки и осуществляет коммутацию слаботочных сигналов постоянного и переменного тока. Подвижным электродом является алюминиевая балка длиной 100 мкм, закрепленная на торсионных подвесах. Контакты выполнены из благородных металлов. В переключателе использован электростатический принцип управления. Напряжение срабатывания составляет от 12 до 45 В, в зависимости от конфигурации. Время переключения составляет 15 мкс. Коммутируемая мощность составляет 25 мВт в частотном диапазоне 0-6 ГГц. Особенностью изделия является механизм активного размыкания, защищающий контакты от залипания. Переключатель обеспечивает более 5×104 циклов коммутации. Модифицированное изделие (рисунок б) развивает в несколько раз большую силу прижима контактов по сравнению со стандартным исполнением (рисунок а). Увеличенное контактное усилие снижает контактное сопротивление и увеличит его стабильность.
РЭМ-изображения МЭМС-переключателя: (а) стандартное исполнение; б) модифицированное изделие с увеличенной силой прижима контактов.
- Uvarov I.V. Migration of adhesive material in electrostatically actuated MEMS switch // Microelectronics Reliability. – 2021. – Vol. 125. – 114372. https://doi.org/10.1016/j.microrel.2021.114372
- Uvarov I.V., Selyukov R.V., Naumov V.V. Testing of aluminium and its alloys as structural materials for a MEMS switch // Microsystem Technologies. – 2020. – Vol. 26. – P. 1971-1980. https://doi.org/10.1007/s00542-020-04748-2
- Uvarov I.V., Marukhin N.V., Naumov V.V. Contact resistance and lifecycle of a single- and multiple-contact MEMS switch // Microsystem Technologies. – 2019. – Vol. 25. – P. 4135-4141. https://doi.org/10.1007/s00542-018-4279-2
- Uvarov I.V., Kupriyanov A.N. Stiction-protected MEMS switch with low actuation voltage // Microsystem Technologies. – 2019. – Vol. 25. – P. 3243-3251. https://doi.org/10.1007/s00542-018-4188-4
Быстрый электрохимический микродвигатель
Изделие может быть использовано в системах прецизионной доставки лекарств и других микрофлюидных и микроэлектромеханических устройствах. Работа актюатора основана на спонтанной реакции горения водорода и кислорода в нанопузырьках. Устройство обладает уникальными характеристиками: рабочая камера имеет в 10 раз меньшие размеры, чем у существующих актюаторов; время отклика составляет порядка 1 мс, что на 5 порядков меньше времени отклика лучших электрохимических актюаторов; объем, вытесняемый за рабочий цикл, составляет порядка 1 нл, что на 2 порядка меньше, чем у существующих прототипов. Малый вытесняемый объем обеспечивает точную дозировку жидкости, при этом производительность и энергопотребление актюатора остаются на стандартном уровне для МЭМС устройств.
Быстрый электрохимический актюатор: а) фотография устройства с указанием структурных материалов; б) зависимость хода мембраны от времени.
- Uvarov I.V., Melenev A.E., Svetovoy V.B. Fast electrochemical actuator with Ti electrodes in the current stabilization regime // Micromachines. – 2022. – Vol. 13. – 283. https://doi.org/10.3390/mi13020283
- Uvarov I.V., Melenev A.E., Selyukov R.V., Svetovoy V.B. Improving the performance of the fast electrochemical actuator // Sensors and Actuators A: Physical. – 2020. – Vol. 315. – 112346. https://doi.org/10.1016/j.sna.2020.112346
- Uvarov I.V., Melenev A.E., Lokhanin M.V., Naumov V.V., Svetovoy V.B. A fast electrochemical actuator in the non-explosive regime // Journal of Micromechanics and Microengineering. – 2019. – Vol. 29. – 114001. https://doi.org/10.1088/1361-6439/ab3bde
- Uvarov I.V., Lokhanin M.V., Postnikov A.V., Melenev A.E., Svetovoy V.B. Electrochemical membrane microactuator with a millisecond response time // Sensors and Actuators B: Chemical. – 2018. – Vol. 260. – P. 12-20. https://doi.org/10.1016/j.snb.2017.12.159
Электрохимический микронасос для портативных модулей доставки лекарств
Насос содержит три мембранных актюатора, работающих по перистальтической схеме. Актюаторы управляются сериями микросекундных импульсов напряжения переменной полярности, которые создают нанопузырьки водорода и кислорода в рабочей камере, толкающие мембрану вверх. После отключения импульсов пузырьки быстро исчезают в ходе спонтанной реакции между водородом и кислородом, и мембрана возвращается в исходное положение. Этот принцип позволяет актюаторам работать на несколько порядков быстрее по сравнению с традиционными электрохимическими устройствами. В отличие от многих микрофлюидных систем, насос изготавливается традиционными методами микроэлектроники с использованием стеклянных и кремниевых пластин диаметром 100 мм. Актюаторы формируются в слое фоторезиста SU-8 и запечатываются малонапряженной мембраной из нитрида кремния SiNx. Каналы для перекачиваемой жидкости также выполняются в SU-8. Рабочая часть насоса занимает объем около 3 мм3, что на порядок меньше по сравнению с мембранными насосами, известными на сегодняшний день. Расчетная скорость перекачки составляет 1,5 мкл/мин на рабочей частоте 100 Гц, в то время как точность дозировки составляет 0,25 нл. Эти характеристики делают насос привлекательным для использования в портативных устройствах доставки лекарств.
Быстрый электрохимический микронасос: а) поперечное сечение с указанием основных структурных элементов; б) фотография чипа, на вставке показан один из трех актюаторов.
- Uvarov I.V., Shlepakov P.S., Melenev A.E., Ma K., Svetovoy V.B., Krijnen G.J.M. A peristaltic micropump based on the fast electrochemical actuator: Design, fabrication, and preliminary testing // Actuators. – 2021. – Vol. 10. – 62. https://doi.org/10.3390/act10030062
- Uvarov I.V., Lemekhov S.S., Melenev A.E., Svetovoy V.B. Exploding microbubbles driving a simple electrochemical micropump // Journal of Micromechanics and Microengineering. – 2017. – Vol. 27. – 105009. https://doi.org/10.1088/1361-6439/aa8914
Исследование и разработка плазменных процессов технологии микро-наносистемной техники
Исследование плазмохимических процессов травления SiO2, Si, резиста осажденпия полимерной пленки во фторсодержащей ( С4F8, CHF3, С4F8+Ar, CHF3, SF6, O2, их смесях и др.)
Исследование плазменных процессов травления/осаждения осуществляется в реакторе плотной плазмы. Он состоит из разрядной и реакционной камер. Плазма создается в кварцевой цилиндрической камере с помощью двухвиткового индуктора и ВЧ –генератора ( f=13,56 Мгц, W-1,0 кВт) в неоднородном магнитном поле пробочного типа. Из разрядной камеры плазма распространяется в реакционную камеру, внутри которой на охлаждаемом ВЧ электроде устанавливается обрабатываемая подложка. Наложение магнитного поля позволило в несколько раз увеличить плотность ионного потока, бомбардирующего поверхность подложки и равномерностью плотности его распределения. Температура электронов в области подложки составляет 3-6 эВ, Nе ~1011 см-3. Энергия ионов определяется постоянным, отрицательным потенциалом самосмещения, возникающим при подаче заданной ВЧ мощности смещения на электрод.
Внутри реакционной камеры находится тонкостенный металлический экран. Он нагревается плазмой до заданной температуры, определяемой условиями теплобаланса с внешними стенками реактора. В химически активной фторуглеродной плазме управляя температурой стенок реактора можно было изменять скорости рождения и гибели на них радикалов, и следовательно, их концентрацию (Патент .
- Амиров И.И., Морозов О.В., Изюмов М.О. Травление кремния и диоксида кремния в высокоплотной плазме ВЧИ разряда низкого давления. // Химия высоких энергий. 2003. Т.37.№5. С.373-379.
- Амиров И.И., Алов Н.В. Осаждение фторуглеродной полимерной пленки в плазме высокочастного индукционного разряда в перфторциклобутане и его смесей с гексафторидом серы. // Химия высоких энергий. 2006. Т.36.№4. С.35-39.
Процессы анизотропного и селективного травления SiO2 и глубокого травления кварца
В созданном реакторе с горячими стенками для целей микроэлектроники и микротехнологии разработаны процессы травления анизотропного, селективного травления SiO2 трехмерных наноструктур (<100 нм) и глубокого (200 мкм) кварца. С горячими стенками удалось увеличить более чем два раза селективность травления SiO2/Si и предотвратить осаждение на них фторуглеродной пленки, что особенно важно в длительных процессах травления кварца.
Наноколодцы в слое SiO2. Травление через α-Si (60 нм) маску в плазме СНF3+Ar. Селективность SiO2/Si>10
Процессы размерного и анизотропного травления кремния во фторсодержащей плазме SF6+CHF3
Для целей микротехнологии разработаны процессы размерного и анизотропного травления Si. При размерном травлении Si можно управлять отношением скорости его травления в вертикальном и горизонтальном направлениях. При таком способе травления можно осуществлять объемный перенос рисунка маски в слой кремния с разным увеличением по высоте и ширине. Это позволяет сформировать, например, конус.
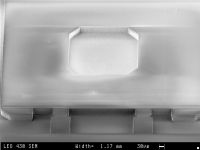
Сквозное травление кварцевой пластинки (200 мкм) через маску Сr. Скорость травления 0,5 мкм/мин, Селективность по отношению к Cr~100
Исследование и разработка плазменных процессов глубокого, анизотропного травления кремния
Проведены исследования процессов глубокого анизотропного травления Si в плазме SF6/C4F8 ВЧИ разряда (Bosch-процесс) для формирования ысокоаспектных микроструктур. Скорость травления Si структур (А<20) достигала 4-6 мкм/мин. Разработаны процессы сквозного травления пластины Si
Для целей микротехнологии в созданном ПХ реакторе с горячими стенками исследованы и разработаны процессы глубокого травления Si через фоторезистивную, SiO2, Cr маски в циклическом, двухстадийном процессе травление/пассивация в плазме SF6/C4F8 (Bosch-процесс). Скорость анизотропного травления Si составляла 10 мкм/мин) и процессы формирования микроструктур каналы и столбики субмикронных размеров (0,5 мкм, высота 42 мкм) с высоким аспектным отношением (А=60). Селективность травления Si/SiO2 более 200.
Приведены исследования условий реализации аспектнонезависимого травления высокоаспектных микроструктур в Bosch-процессе.
- Амиров И.И., Морозов О.В., Изюмов М.О., Кальнов В.А., Орликовский А.А., Валиев К.А. // Плазмохимическое травление глубоких канавок в кремнии с высоким аспектным отношением для создания различных элементов микромеханики. // Микросистемная техника. 2004. Т.12. С.15-18.
- Амиров И.И., Морозов О.В., Постников А.В., Кальнов В.А., ОрликовскийА.А., Валиев К.А. Плазменные процессы глубокого травления кремния в технологии микросистемной техники. Труды ФТИАН. Квантовые компьютеры, микро-наноэлектроника. М.Наука. 2009.Т.20. С.159-174.
Моделирование формирования высоко-аспектных Si микроструктур в Bosch – процессе
Разработан метод 2-мерного моделирования циклического травление/пассивация процесса (Bosch – процесс) формирования глубоких канавок в Si. Метод основан на методе ячеек для эволюции профиля поверхности структур и методе Монте-Карло генерации потоков плазмы.
Метод моделирования реализован в созданном интерактивном программном комплексе, который предоставляет широкие возможности для проведения численных экспериментов моделирования.
С помощью разработанного метода впервые было осуществлено моделирование формирования глубоких высокоаспектных (A>10) канавок субмикронных размеров в Si в Bosch-процессе в плазме SF6/C4F8. Сравнение результатов моделирования с экспериментальными данными подтверждает правильность модели. Показано, что в условиях аспектнозависимого (АЗ) травления глубоких канавок в Si скорость процесса определяется доставкой атомов фтора на дно глубоких канавок.
Моделирование подтверждает существование широкого ряда эффектов искажения профиля канавок при травлении Si в Bosch‑процессе в плазме SF6/C4F8. Показано, что, изменяя управляющие параметры в течение процесса можно варьировать форму субмикронных канавок. Определены условия формирования канавок с разным углом наклона боковых стенок, возникновения апертурного эффекта, достижения аспектнонезависимого (АНЗ) травления.
- Шумилов А.С., Амиров И.И.. Моделирование формирования глубоких канавок в кремнии в плазмохимическом, циклическом травление/пассивация процессе // Микроэлектроника. 2007. Т.36. № 4 С.
- Амиров И.И., Алов Н.В. Формирование микроструктур на поверхности кремния во фторсодержащей плазме в циклическом процессе травление/пассивация. Химия высоких энергий. 2008. Т.41.№4. С.35-39.
- Амиров И.И., Шумилов А.С. Механизм формирования микроигл на поверхности кремния во фторсодержащей плазме в циклическом травление/осаждение процессе. // Химия высоких энергий. 2008. Т.41.№5. С.35-39.
Разработка технологии, конструкции и создание приборов микро - наносистемной техники (микро- и нанорезонансных систем, микроактюаторов, микроакселерометров, микропереключателей и др.)
На базе плазменных процессов глубокого анизотропного травления кремния были разработаны технологии изготовления чувствительных элементов инерциальных датчиков микрогироскопов, микроакселерометров и микроактюаторов. Их использование позволило перейти к изготовлению трехмерных чувствительных элементов, что позволило резко увеличить их чувствительность датчиков. В технологии изготовления микроакселерометра использовались плазменные процессы объемного травления Si и травления высокоаспектных микроструктур.
Для изготовления микроприводов (микро-актюаторов) с большим диапазоном перемещения была разработана новая технология. Она основывается на концепции формирования в объеме кремниевой пластины изолированных SiO2 блоков. Это позволило без использования доростоящих Si пластин со структурой «кремний-на изоляторе» получать электрически изолированные микроэлементы на пластине. С использованием данной технологии был изготовлен электростатический микроактюатор с диапазоном перемещения 10 мкм, управляющим напряжением 24 В.
Разработана технология и изготовлены электро-статические емкостные микропереключатели консольного-балочного типа на основе многослойных (трех и пятислойных) металлических консолей (кантеллеверов) и микромостиков - Сr/Al/Cr, Сr/Al/Cr/Al/Cr с толщиной слоев металлов 50/250/50 нм. Определены их амплитудно-частотные характеристики. Основные резонансные частоты микрорезонаторов лежат в области 10 кГц.
Изготовлены нанорезонаторы балочного типа – балки, имеющие толщину менее 100 нм. Материал балок – три слоя металла (Cr/Al/Cr). Балки имеют длину от 20 до 40 мкм и ширину от 2 до 6 мкм. Измеренные резонансные частоты балок достигают 1 МГц.
- A. V. Postnikov; I. I. Amirov; V.V. Naumov; V. A. Kalnov. Simulation, fabrication, and dynamics characteristics of electrostatically actuated switches. // Proceedings of SPIE. 2008. Vol. 7025.
Измерение динамических характеристик микро- и наномеханических элементов
Создан измерительный стенд и отработана методика измерения динамических характеристик чувствительных элементов (ЧЭ) МЭМС и НЭМС. Работа стенда основана на методе «светового рычага»: колебания подвижного механического элемента регистрируются по отклонению лазерного луча, отраженного от его поверхности. Динамические характеристики (резонансные частоты, добротности) ЧЭ определяются по измеренным резонансным кривым. Стенд собран на оптическом столе. Фотография стенда, схема, показывающая принцип работы, а также пример получаемых резонансных кривых, представлены ниже.
Достоинства измерительного стенда:
- - Размер лазерного пятна, сфокусированного на поверхности ЧЭ, составляет порядка 5 мкм;
- - Стенд может регистрировать угловое отклонение ЧЭ как в одной плоскости (двухсекторный фотоприемник), так и одновременно в двух плоскостях (четырехсекторный фотоприемник);
- - Диапазон измеряемых резонансных частот и добротностей ЧЭ ограничивается лишь возможностями генератора, задающего частоту возбуждения, а также быстродействием фотоприемника и вольтметра. При замене какого-либо из этих устройств не требуется перестраивать оптическую систему стенда;
- - Вакуумная система стенда позволяет тестировать ЧЭ при давлениях воздуха в диапазоне от 10-4 до 105 Па. Этот диапазон давлений достаточно широк, чтобы проверить работу ЧЭ в любом из доступных режимов воздушного демпфирования;
- - Метод «светового рычага» не требует подключения образца к сложной электронике (в отличие, например, от емкостного метода регистрации колебаний). Достаточно лишь сфокусировать лазерный луч на поверхность образца и возбудить колебания образца тем или иным способом.
- - Стенд легко настраивается и модифицируется (например, большая вакуумная камера с множеством вакуумных вводов позволяет организовать подачу в камеру различных газов, нагрев или охлаждение образцов).
- Уваров И.В., Козин И.А., Амиров И.И. Исследование влияния давления воздуха на динамику чувствительного элемента микромеханических устройств. // Вестник ЯрГУ. Серия Естественные и технические науки, 2010, №2, стр. 38-42.
- Уваров И.В., Морозов О.В., Козин И.А., Постников А.В., Амиров И.И., Кальнов В.А. Динамические характеристики чувствительного элемента микроакселерометра с повышенным фактором демпфирования. // Нано- и микросистемная техника, 2011, № 12, с. 38-40.
- Козин И.А., Постников А.В., Моpозов О.В. Исследование динамики микроэлектромеханических устройств с нанесенной металлизацией. // Нано- и микросистемная техника, 2011, № 12, с. 43-45.
- Уваров И.В., Наумов В.В., Аминов М.К., Куприянов А.Н., Амиров И.И. Исследование резонансных характеристик металлических микро- и нанобалок. // Нано- и микросистемная техника, 2011, № 12, с. 45-48.
Исследование и разработка процессов магнетронного нанесения пленок металлов диэлектриков и полупроводников для целей микротехнологии
На основе исследования влияния ионной бомбардировки на свойства осаждаемых пленок металлов были разработаны следующие уникальные технологические процессы:
- - Эпитаксия ниобия на подложке сапфира при комнатной температуре. Без ее использования температура подложки должна быть не менее 600°С.
- - Нанесение высокотекстурированных пленок металлов, обладающих электрической проводимостью как у массивных металлов. Обычно, проводимость пленочных металлов хуже, чем массивных.
- - Нанесение износостойких покрытий CrOx на головки считывания информации с магнитных лент (стримеров). Срок службы головок был увеличен в 3 раза.
- - Создание антидиффузионного покрытия для лопаток газовых турбин и авиационных двигателей. Покрытие AlOx с переменным содержанием кислорода располагалось на поверхности лопатки до нанесения защитного слоя ZrO2, для предотвращения диффузии кислорода в лопатку из этого слоя. Критическая температура начала диффузии была поднята от 800°С до 1000°С.
Разработаны процессы нанесения сверхтонких магнитных пленок для получения многослойных структур, обладающих гигантским магнетосопротивлением (ГМС). Проведены исследования магнитных свойств таких пленок и структур магнитооптическиим методом. экваториальный эффект Керра (ЭЭК).
Продольное (пунктирные линии) и поперечное (жирные линии) магнетосопротивление структур (Co/Cu)5/Co полученные: а) с использованием смещения, б) без смещения.
- Наумов В.В., Бучин Э.Ю. Магнетосопротивление многослойных структур, полученных магнетронным методом. Микроэлектроника. 2009. Том 38. № 5. С. 369-373
- В.В. Наумов, В.Ф. Бочкарев, Э.Ю. Бучин. Увеличение адгезии металлических пленок к кремнию с помощью ионной бомбардировки в процессе их роста. ЖТФ. 2009. Том 79. Вып. 7. С. 146-149.
- Наумов В.В., Папорков В.А., Лоханин М.В.. Зависимость экваториального эффекта Керра от угла падения света для сверхтонких пленок кобальта и мультислоев Сo/Сu/Сo. Микроэлектроника. 2009. Том 38. № 4. С. 273-279.