Лаборатория физики и технологии наноструктур
Руководитель структурного подразделения д.ф-м.н. Мордвинцев В.М.Основные направления исследований
Исследование процессов самоформирования проводящих наноструктур в сильных электрических полях (электроформовки)

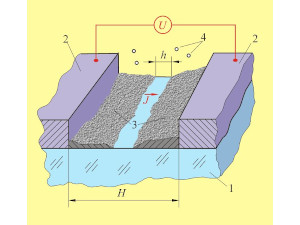
Рис. 1. РЭМ-изображение планарной МИМ (металл-изолятор-металл)-структуры после электроформовки (видна самосформировавшаяся изолирующая щель в плёнке золота) и схематическое изображение возникающей наноструктуры с шириной изолирующего зазора h=1 – 4 нм. 1 – диэлектрическая подложка, 2 – металлические электроды, 3 – возникающая проводящая среда, 4 – молекулы в газовой фазе.
Изучаются процессы самоформирования проводящих наноструктур в виде изолирующего зазора (рис. 1) нанометровой ширины в возникающей проводящей среде при воздействии высоких электрических полей (создаваемых напряжением U) и протекании тока J по поверхности изолирующей щели шириной H (процесс электроформовки). Проводящая среда формируется путём образования и накопления частиц проводящей фазы за счёт деструкции молекул диэлектрика (поверхностных слоёв изолятора) при электронном ударе. Состояние проводящей среды меняется при взаимодействии с молекулами газовой фазы и потоком электронов. Ширина h изолирующего зазора зависит от приложенного напряжения, но в любом случае она находится в диапазоне нескольких нанометров. Образующиеся проводящие наноструктуры обладают рядом нетривиальных электрических свойств: N-образными вольтамперными характеристиками (ВАХ), эффектами бистабильности (переключения) и памяти. Поэтому электроформованные структуры обладают свойствами мемристоров.
Экспериментальные исследования выполняются на объектах в виде открытых «сэндвич»-МДМ (металл-диэлектрик-металл)-структур (рис. 2), в которых ширина H изолирующей щели в виде свободного торца, диэлектрической плёнки, открытого в газовую фазу (вакуум), задаётся её толщиной d. Толщина плёнки диэлектрика находится в диапазоне 15 – 30 нм, что позволяет создавать высокие электрические поля, а открытость в газовую фазу обеспечивает проводимость структуры без разрушения металлических электродов. Изучается влияние на процесс электроформовки и свойства формирующихся наноструктур различных физических и технологических факторов: материалов электрода и диэлектрика, ширины изолирующей щели, амплитуды, длительности и формы импульсов напряжения U между электродами, состава и давления газовой фазы, различных обработок поверхности и др. (см. ниже в последнем разделе).
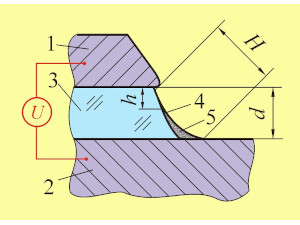
Рис. 2. Схематическое изображение
открытой «сэндвич»-МИМ-структуры.
1, 2 – металлические электроды;
3 – диэлектрическая плёнка толщиной d;
4 – изолирующая щель шириной H;
5 – формирующаяся проводящая среда.
Рис. 3 иллюстрирует основные электрические свойства электроформованных структур: N-образные ВАХ, а также эффекты переключения и памяти. Исходно структура находилась в низкопроводящем состоянии (OFF) с относительно большой шириной h изолирующего зазора. После достижения порогового напряжения Uth происходит быстрое переключение структуры в высокопроводящее состояние (ON) с малым (около 1 нм) значением h. Отношение токов в состояниях OFF и ON может составлять 3 – 4 порядка. Обратное переключение осуществляется импульсом напряжения длительностью менее 10-2 с и амплитудой, превышающей напряжение максимума ВАХ. Неразрушающее считывание информации о состоянии структуры возможно при напряжениях меньше Uth.

Рис. 3. Типичные N-образные ВАХ и эффект переключения в открытых «сэндвич»-структурах Si-SiO2-W после электроформовки.
Такие свойства позволяют создать на основе электроформованных структур, обладающих характеристиками мемристоров, энергонезависимое электрически перепрограммируемое запоминающее устройство (память на самоформирующихся проводящих наноструктурах), информация в котором кодируется фактически шириной h нанометрового изолирующего зазора.
Разработка физико-технологических основ энергонезависимой электрически перепрограммируемой памяти на электроформованных структурах (мемристорах)
Элемент памяти выполняется в виде электроформованной открытой «сэндвич»-МДМ-структуры (рис. 2), электроды и диэлектрическая плёнка которой могут изготавливаться из различных материалов. В ходе работ над памятью были опробованы несколько вариантов конструкции ячеек. В таблице 1 приведены этапы её разработки и исследований.
| Базовая конструкция элемента памяти | Какие проблемы решены | Какие проблемы поставлены |
| Al-Al2O3-W 1995 – 1997 гг. |
1. Проверка идеи открытой «сэндвич» структуры для выполнения электроформовки. 2. Демонстрация эффектов переключения и памяти. |
1. Низкая стабильность состояний элементов памяти. 2. Невозможность соединить элементы памяти в матрицу. |
| pSi-SiO2-W 1998 – 2002 гг. |
1. Соединение элементов памяти в матрицу. 2. Состояния элементов памяти стали термически и радиационно стойкими. |
Малая достижимая размерность матрицы памяти из-за высокого сопротивления шин р-Si и больших токов утечки |
| n+Si-SiO2-W 2003 – 2006 гг. |
1. Сняты жёсткие ограничения на размерность матрицы памяти. 2. Возможность увеличения скорости записи на несколько порядков. |
Плохое согласование технологии изготовления матрицы памяти с типовой кремниевой технологией |
| n+Si-TiN-SiO2-W 2007 – 2012 гг. |
Конструкция согласована с типовой кремниевой технологией, поэтому возможно изготовление матрицы памяти на одном чипе со схемами управления | Высокая вероятность электрического пробоя структуры при выполнении электроформовки для матриц больших размерностей |
| n+Si-TiN-TiO2-SiO2-W 2012 – 2016 гг. |
Существенное уменьшение вероятностей электрических пробоев структур при изготовлении (электроформовке) и эксплуатации | Жесткие требования к составу и давлению газовой среды над матрицей памяти |
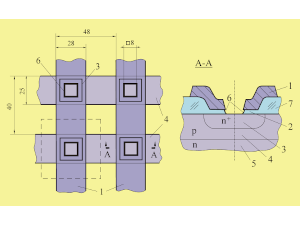
Рис. 4. Схематическое изображение фрагмента матрицы памяти в плане и сечения ячейки памяти для варианта конструкции на основе открытой «сэндвич»-структуры n+Si-SiO2-W. 1 – верхняя проводящая шина W (верхний электрод элемента памяти), 2 – слой тонкого SiO2, 3 – эмиттер транзистора (нижний электрод элемента памяти), 4 – нижняя проводящая шина р-Si (база транзистора), 5 – подложка n-Si (коллектор транзистора), 6 – изолирующая щель (открытый торец диоксида кремния), 7 – слой толстого диоксида кремния. Размеры даны в микрометрах.
На рис. 4 показана конструкция ячейки и матрицы памяти на основе элемента памяти со структурой n+Si-SiO2-W. Открытый торец 6 плёнки диоксида кремния – собственно элемент памяти – представляет собой квадрат в плане и встроен в эмиттер биполярного транзистора, который обеспечивает электрическую развязку ячеек в матрице. РЭМ-изображение образца такой матрицы размерностью 3×3 ячейки показано на рис. 5. Разработана лабораторная технология изготовления экспериментальных образцов матрицы памяти, которые продемонстрировали полный набор функций энергонезависимого электрически перепрограммируемого запоминающего устройства: запись, стирание, хранение, неразрушающее считывание информации, а также возможность выборки индивидуальной ячейки во всех режимах.
Рис. 5. РЭМ-изображение матрицы памяти размерностью 3×3 ячейки. Горизонтальные полосы – шины W.
Исследование характеристик памяти на электроформованных структурах (мемристорах)
Высокая радиационная стойкость энергонезависимой электрически перепрограммируемой памяти на проводящих наноструктурах связана с тем, что в отличие от традиционной полупроводниковой памяти, где носителем информации является зарядовое состояние диэлектрика, в ней информация кодируется размерами проводящей наноструктуры. Это свойство является одним из основных технических достоинств, делающих перспективным применение такой памяти в космической, атомной и военной отраслях.
Наиболее критичным параметром для энергонезависимой электрически перепрограммируемой памяти вообще является величина накопленной дозы облучения, при которой не происходит нарушение состояния ячейки. В связи с этим, методика испытаний состояла в измерении ВАХ ячеек, находящихся в различных состояниях (высоко- и низкопроводящем), в процессе облучения.
Выполнен большой объём исследований радиационной стойкости для различных вариантов конструкции ячейки памяти. На рис. 6 показаны типичные результаты для конструкции на базе открытой «сэндвич»-структуры TiN-SiO2-W. В этих образцах не было зафиксировано заметных изменений ВАХ каждого из 9 элементов памяти (ЭП) в матрице для двух режимов функционирования: хранения и считывания информации, - и для обоих состояний: высоко и низкопроводящего, - при дозах облучения более 1 Мрад.


Рис. 6. ВАХ ячеек матрицы памяти до облучения (а) и после облучения (б) дозой 1 Мрад последовательно в режиме хранения и считывания информации.
| Режим | Выбранный элемент памяти (m, n) | Невыбранный элемент памяти (i, j) |
| Считывание | U(Wn): импульс амплитудой (–1÷1,5) В, длительность (1÷100) мкс; U(Pm) = 0 В. Ток в W шине (или подложке): OFF – менее 0,1 мкА, ON – более 1 мкА |
U(Wj) = 0 В; U(Pi) = (–1÷1,5) В; Uп = 0 В |
| «Включение» (OFF→ON) |
1. U(Wn): импульс амплитудой – 5 В, длительность 1 мс (Rb=10 – 15 кОм); U(Pm)=0 В; 2. Считывание состояния; 3. Если оно не ON, повторение пп. 1 |
U(Wj) = 0 В; U(Pi) = –6 B; Uп = 0 В |
| «Выключение» (ON→OFF) | U(Wn): импульс амплитудой – 6 В, длительность 200 нс; U(Pm) = 0 В |
U(Wj) = 0 В; U(Pi) = –6 B; Uп = 0 В |
| U(W) – напряжение на вольфрамовой шине; U(P) – напряжение на кремниевой шине; Uп – напряжение на подложке. | ||
В табл. 2 приведены основные характеристики управляющих импульсов для всех режимов функционирования матрицы памяти на основе открытой «сэндвич»-структуры TiN-SiO2-W.
Уникальное сочетание достоинств энергонезависимой электрически перепрограммируемой памяти на проводящих наноструктурах: потенциально высокая плотность записи информации, высокое быстродействие при записи и считывании, высокая термическая и радиационная стойкости, возможность изготовления методами традиционной кремниевой технологии и на одном чипе со схемами управления, - делают её практическое использование не только возможным, но и привлекательным.
Влияние на процесс электроформовки и свойства формирующихся наноструктур различных физических и технологических факторов
1. Исследования процессов электроформовки и переключений элемента памяти при различных полярностях напряжений и материалах электродов
Наличие n-p-n-транзистора в ячейке памяти обуславливало ранее возможность использования только одной полярности напряжения собственно на МДМ-структуре (минус на верхнем вольфрамовом электроде). С целью исследования влияния полярности на процессы электроформовки и переключений элемента памяти, а также ВАХ после электроформовки, транзистор был исключён из ячейки.
Было обнаружено существенное различие в поведении структуры TiN-TiO2-SiO2-W при положительной (плюс на верхнем электроде) и отрицательной полярности напряжения. В первом случае электроформовка шла значительно более надёжно, а типичные (А-тип) квазистатические ВАХ после электроформовки выглядели, как показано на рис. 7а. Причём такие кривые могли прорисовываться многократно. Во втором случае наблюдалась повышенная вероятность пробоя при выполнении электроформовки, а типичные (В-тип) ВАХ показаны на рис. 7б. Как видно, уже при первом проходе при напряжениях около максимума тока происходил пробой, после чего переключения структур становились невозможными.
Такие различия, в принципе, могли быть связаны не только с полярностью напряжения, но и с разными материалами верхнего и нижнего электродов, а также с разной формой изолирующей щели для электронов, эмитируемых из нижнего или верхнего положений катода. С целью установления основного из этих возможных факторов была выполнена серия экспериментов для структур с различными материалами электродов. При этом технология их изготовления отличалась минимально. Полученные результаты сведены в табл. 3.
| Структура Mbot-D-Mtop (№) |
Тox, ºС |
d, nm |
Ubr, V |
Параметры электроформовки | Тип ВАХ | ||||
| полярность: | полярность: | ||||||||
| + | – | + | – | ||||||
| Ns/Ntot | UF, V | Ns/Ntot | UF, V | ||||||
| TiN-TiO2-SiO2-W (1) |
350 | 26,0 | 23,6 | 12/13 | 10,5 – 17,5 | 2/9 | 10,5 – 16,5 | A | B |
| TiN-TiO2-SiO2-W (2) |
440 | 22,0 | 21,3 | 28/33 | 9,5 – 12,5 | 7/9 | 10,5 – 12,5 | A | B |
| W-SiO2-TiN (3) |
350 | 27,4 | 16,4 | 0/4 | 12,5 – 14,5 | 10/11 | 12,5 – 14,5 | B | A |
| W-SiO2- TiO2-TiN (4) |
350 | 27,3 | 18,1 | 2/12 | 10,5 – 14,5 | 15/16 | 10,5 – 14,5 | B | A |
| W-SiO2-W (5) |
350 | 27,0 | 12,3 | 3/9 | 6,5 – 9,5 | 3/13 | 6,5 – 8,5 | A | A |
| W-SiO2-W (6) |
350 | 27,7 | 10,9 | 7/10 | 7,5 – 9,5 | 9/14 | 6,5 – 8,5 | A | A |
| TiN-SiO2-TiN (7) |
350 | 22,9 | 22,6 | 5/12 | 10,5 – 16,5 | 7/12 | 14,5 – 18,5 | B-80% A-20% |
B-80% A-20% |
| TiN-SiO2-TiO2-TiN (8) |
350 | 24,3 | 21,4 | 8/17 | 8,5 – 16,5 | 8/8 | 8,5 – 10,5 | B-80% A-20% |
B-80% A-20% |
Tox – температура осаждения SiO2 и экспозиции в кислородной плазме. Ubr – напряжение пробоя. UF – напряжение электроформовки. Nt – общее количество исследованных структур. Ns – количество структур с успешной электроформовкой.
Анализ полученных данных позволяет сделать однозначные заключения. Во-первых, ВАХ А-типа наблюдаются, когда анод структуры изготовлен из W при любом (верхнем или нижнем) положении этого электрода. Во-вторых, ВАХ В-типа наблюдаются, когда анод структуры изготовлен из TiN при любом (верхнем или нижнем) положении этого электрода. В частности, всё это означает, что форма изолирующей щели не влияет на тип ВАХ. Таким образом, основной фактор, ответственный за стабильную электроформовку и отсутствие электрического пробоя при снятии квазистатических ВАХ – это изготовление анода структуры из вольфрама. Если оба электрода структуры выполнены из вольфрама, ВАХ А-типа наблюдается для обеих полярностей напряжения (рис. 7а). В-третьих, наличие слоя TiO2 относительно большой толщины на поверхности Ti не влияет на тип ВАХ. Слой TiO2 с повышенной толщиной формировался либо увеличенной температурой Tox (сравнить строки 1 и 2 табл. 3), либо дополнительным осаждением (сравнить строки 7 и 8 табл. 3).
Физические причины таких эффектов пока не ясны, однако практический вывод из них очевиден: анод открытой МДМ-структуры для электроформовки и последующего использования её в качестве элемента памяти должен быть изготовлен из вольфрама и может быть как верхним, так и нижним.
2. Влияние состава и давления газовой среды на процессы переключения мемристоров на основе электроформованных открытых «сэндвич»-структур
Поскольку при электроформовке проводящая наноструктура, ответственная за последующие переключения элемента памяти, образуется на открытом торце «сэндвич»-МДМ-структуры, эти процессы могут быть чувствительны к составу и давлению газовой среды над изолирующей щелью. Влияние кислорода на электроформовку было исследовано ранее. Оно состоит в подавлении этого процесса при слишком высоких концентрациях кислорода в газовой фазе. Отдельный интерес представляет влияние кислорода на процессы переключения элемента памяти после его изготовления путём электроформовки.
Соответствующий комплекс исследований был выполнен для электроформованных открытых «сэндвич»-структур TiN-TiO2-SiO2-W при использовании верхнего вольфрамового электрода в качестве анода. Основные результаты сведены в диаграмму, показанную на рис. 8. Экспериментальные данные демонстрируют наличие порогового давления кислорода Pth, выше которого становится невозможным импульсное «включение» (переключение из низко- в высокопроводящее состояние) элементов памяти. Пороговое давление экспоненциально зависит от значения тока Ilim ограничения во время действия импульса «включения» в некотором диапазоне Ilim. Кроме того, на соответствующей кривой наблюдаются (это хорошо видно для кривой 1) две «полочки»: при малых и больших токах. Полученные результаты могут быть объяснены, исходя из самых общих физических представлений и предлагаемых механизмов процессов накопления и исчезновения частиц проводящей фазы в электроформованных структурах.
Было исследовано также влияние режима электроформовки (тока ограничения Ilimf в ходе электроформовки) на зависимость Pth(Ilim). Продемонстрировано наличие сдвига кривой (сравнить кривые 1 и 2 на рис. 8) для различных значений Ilimf, которое может быть объяснено соответствующим изменением размеров образующейся проводящей наноструктуры. На основе полученных экспериментальных данных (соотношения Ilim1 и Ilim2) проведена оценка изменения размеров и удельного поверхностного сопротивления материала проводящей среды при изменении Ilimf, которая соответствует увеличению «компактности» наноструктуры с его уменьшением. Существенно, что при Ilimf=60 мкА (кривая 2) элемент памяти функционирует, т. е. сохраняются его переключения, вплоть до давлений кислорода, близких к атмосферному. Полученные результаты, в частности, позволили предложить обоснованную методику выбора режимов выполнения электроформовки открытых «сэндвич»-структур.
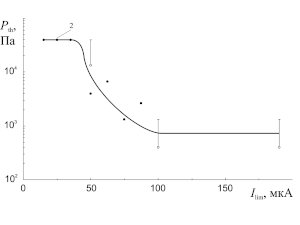
Рис. 8. Зависимости порогового давления Pth кислорода, при котором элемент памяти перестаёт «включаться», от тока ограничения Ilim при переключениях для различных токов ограничения при электроформовке Ilimf: 1 – 190 мкА, 2 (с экспериментальными точками) – 60 мкА.
Соответствующие эксперименты с инертными газами (азотом и аргоном) продемонстрировали отсутствие их влияния на процессы переключения электроформованных структур при любых давлениях вплоть до атмосферного.
Таким образом, экспериментально показано, что существуют электрические режимы, в которых переключения между низко- и высокопроводящим состояниями элемента памяти нечувствительны к составу и давлению газовой среды.
- Мордвинцев В.М., Левин В.Л. Возможный механизм формирования N-образной вольтамперной характеристики МИМ-диода // ЖТФ. 1994. Т. 64. Вып. 12. С. 88-100.
- Мордвинцев В.М., Левин В.Л. Модель возникновения N-образной стационарной вольтамперной характеристики нано-металл-изолятор-металл-диода с углеродистой активной средой // ЖТФ. 1996. Т. 66. Вып. 7. С. 83-95.
- Валиев К.А., Левин В.Л., Мордвинцев В.М. Электроформовка как процесс самоорганизации нанометрового зазора в углеродистой среде // ЖТФ. 1997. Т. 67. Вып. 11. С. 39-44.
- Мордвинцев В.М., Левин В.Л. Модель нано-МИМ-диода с углеродистой активной средой с учётом перколяции в изолирующей щели // Микроэлектроника. 1998. Т. 27. № 4. С. 265-274.
- Мордвинцев В.М., Кудрявцев С.Е. Особенности процесса электроформовки в открытых «сэндвич»-структурах Si-SiO2-W с нанометровой изолирующей щелью // Микроэлектроника. 2001. Т. 30. № 5. С. 353-363.
- Мордвинцев В.М., Кудрявцев С.Е. Условия формирования единичной проводящей наноструктуры при электроформовке // ЖТФ. 2002. Т. 72. Вып. 4. С. 53-59.
- Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Качественное различие механизмов процесса электроформовки в структурах Si-SiO2-W для Si n- и р-типов проводимости // ФТП. 2005. Т. 39. Вып. 2. С. 222-229.
- Мордвинцев В.М., Кудрявцев С.Е. Исследование проводимости и электроформовки открытых «сэндвич»-структур Si-SiO2-W на высоколегированном кремнии // Микроэлектроника, 2007, Т. 36, № 6, С. 423-436.
- Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Электроформовка как процесс самоформирования проводящих наноструктур для элементов энергонезависимой электрически перепрограммируемой памяти // Российские нанотехнологии. 2009. Т. 4. № 1-2. С. 174-182.
- Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Высокостабильная энергонезависимая электрически перепрограммируемая память на самоформирующихся проводящих наноструктурах // Российские нанотехнологии. 2009. Т. 4. № 1-2. С. 183-191.
- Мордвинцев В.М, Кудрявцев С.Е., Левин В.Л., Цветкова Л.А. Влияние давления газовой среды и длительности управляющих импульсов на стабильность характеристик элементов памяти на основе электроформованных структур Si-SiO2-W // Микроэлектроника. 2010. Т. 39. № 5. С. 337-347.
- Мордвинцев В.М., Согоян А.В., Кудрявцев С.Е., Левин В.Л. Исследование радиационного поведения ячеек энергонезависимой электрически перепрограммируемой памяти на самоформирующихся проводящих наноструктурах. I. Режим хранения информации // Микроэлектроника. 2011. Т. 40. № 2. С. 98-108.
- Мордвинцев В.М., Кудрявцев С.Е. Исследование электрических характеристик элементов памяти на самоформирующихся проводящих наноструктурах в виде открытой «сэндвич»-структуры TiN-SiO2-W // Микроэлектроника. 2013. Т. 42. № 2. С. 93-104.
- Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Память на основе явления электроформовки // Кремниевые наноструктуры. Физика. Технология. Моделирование. Ярославль. Издательство ИНДИГО. 2014. С. 493-559. ISBN 978-5-91722-225-7.
- Мордвинцев В.М., Наумов В.В., Симакин С.Г. Исследование процесса образования окисной плёнки нанометровой толщины на поверхности нитрида титана методом вторично-ионной масс-спектрометрии // Микроэлектроника. 2016. Т. 45. № 4. С. 258-272.
- Мордвинцев В.М., Кудрявцев С.Е. Влияние особенностей конструкции изолирующей щели открытых «сэндвич»-структур TiN-SiO2-W и Si-SiO2-W на процесс их электроформовки // Микроэлектроника. 2017. Т. 46. № 4. С. 266-274.
- Мордвинцев В.М., Кудрявцев С.Е., Левин В.Л. Влияние толщины слоя диоксида кремния на процесс электроформовки в открытых «сэндвич»-структурах TiN-SiO2-W // ЖТФ. 2018. Т. 88. Вып. 11. С. 1681-1688.
- Мордвинцев В.М., Наумов В.В, Симакин С.Г. Влияние давления кислорода на процесс окисления поверхности нитрида титана в плазме // Микроэлектроника 2019. Т. 48. № 6. С. 460–466.
- Мордвинцев В.М., Горлачев Е.С., Кудрявцев С.Е., Левин В.Л. Влияние давления кислорода на переключения в мемристорах на основе электроформованных открытых «сэндвич»-структур // Микроэлектроника. 2020. Т. 49. № 4. С. 287-296.
- Мордвинцев В.М., Горлачев Е.С., Кудрявцев С.Е. Влияние режима электроформовки на устойчивость переключений мемристоров на основе открытых «сэндвич»-структур в среде кислорода // Микроэлектроника. 2021. Т. 50. № 3. С. 175–183.
- E.S. Gorlachev, V.M. Mordvintsev, S.E. Kudryavtsev Study of inert gas pressure influence on electroforming and resistive switching of TiN-TiO2-SiO2-W memristors // Proc. SPIE 12157, International Conference on Micro and Nano-Electronics 2021, 121570C (30 January 2022).
- S.E. Kudryavtsev, V.M. Mordvintsev, V.V. Naumov, E. S. Gorlachev Effect of electrodes material on the I-V-curve and switching of memristors on the base of electroformed open metal-SiO2-metal sandwich structure // Proc. SPIE 12157, International Conference on Micro- and Nano-Electronics 2021, 121570D (30 January 2022).
- Мордвинцев В.М., Горлачев Е.С., Кудрявцев С.Е. О механизме образования проводящей среды в мемристорах на основе электроформованных открытых «сэндвич»-МДМ-структур // Микроэлектроника. 2022. Т. 51. № 4. С. 304–312.



